Electron Beam Lithography System: Raith EBPG5150 100kV
The EBPG5150 Electron Beam Lithography (EBL) System is an ultra-high performance e-beam writer for nanodevice fabrication. Equipped with GenIsys Beamer and Tracer data prep software, this EBL system produces ultrafine and dense patterns. The immense beam current (up to 350 nA) enables fast writing on 3’’, 4’’ and 5’’ substrates. The automatic calibration of beam and alignment (every 10mins) allows long-time writing with high quality pattern and high accuracy of alignment.
…………………………………………………………………………………………………………………………………………………………………
Key Features
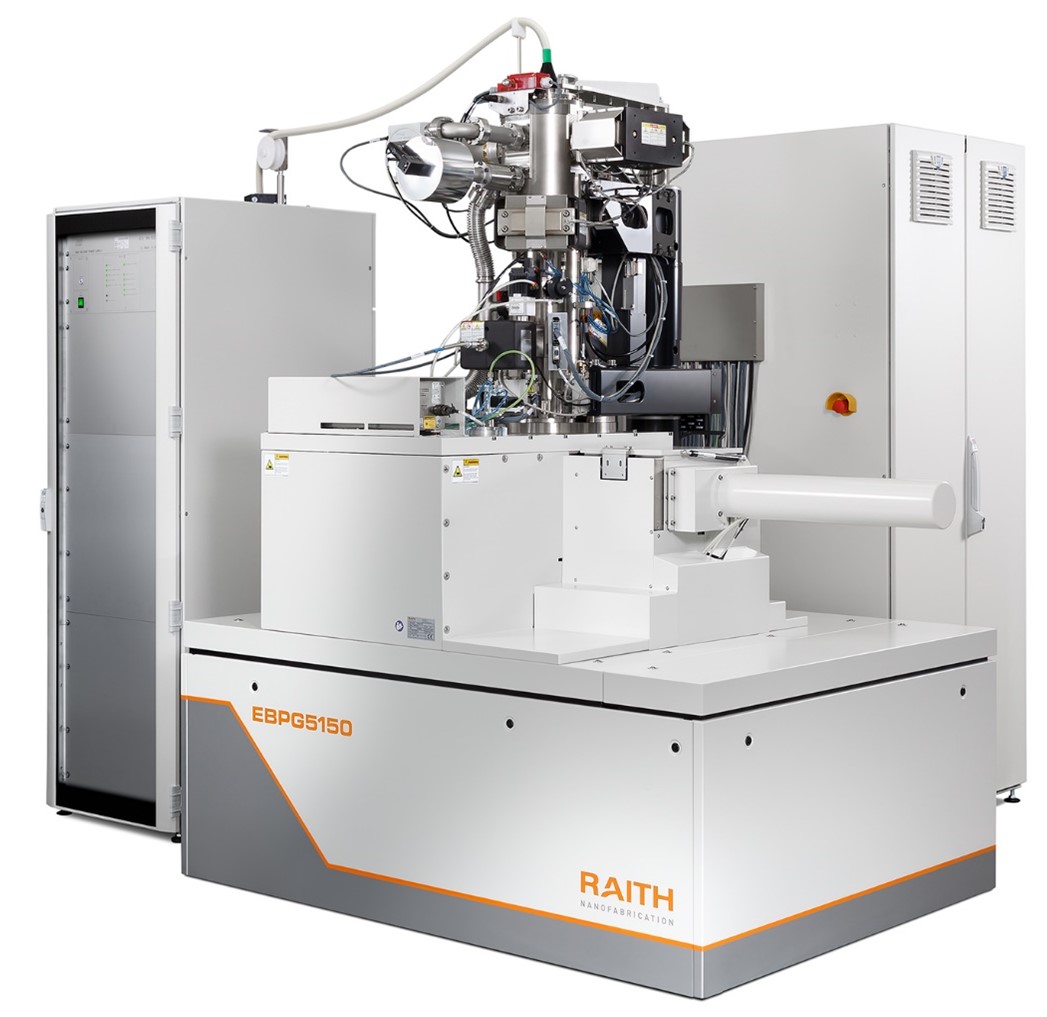
- Thermal Field Emission Gun
- 50 and 100 kV beam energy calibration (primary voltage 100kV)
- Automatic dynamic correction for off-axis focus, stigmation and distortion
- 125 MHz pattern generator, low noise 20-bit main field deflection
- Increased Field size operation, variable, up to 1,048 μm by 1,048 μm at all voltages
- Large beam current up to 350 nA
- Overlay accuracy smaller than 5 nm
- Minimum feature size < 8 nm
- 155 mm by 155 mm stage travel
- Lambda/1024 (0.6 nm) laser interferometer resolution
- 10-holder Airlock with “straight through” loading design
- 5” Mask Holder, 3’’ and 2’’ wafer holder, and small pieces holders
- Binocular microscope with X/Y stage and Z measurement to pre-align wafers and piece-parts on their holder prior to system loading
- System control software suite “BEAMS” on fully integrated control PC running Linux OS with Ethernet Interface
- GenlSys Beamer Data Prep Package including PEC and Tracer
Key Applications and available processes
- Semiconductor nanoelectronics devices
- Photonic and plasmonic nanodevices
- Superconducting quantum devices
Contact
General Documentation
Pending development: EBPG150 system SOP (standard operation procedure)
Check Availability
Already have an account?
Reserve this tool with the FOM.
Need an Account?
Equipment Fee
Fabrication Service 2
